-

Dynabook presenta la edición limitada del portátil 'Ghost in the Shell: Stand Alone Complex'
Dynabook anuncia una computadora portátil 'Ghost in the Shell: Stand Alone Complex' de edición limitada, que combina la estética icónica del anime con hardware moderno y un conjunto completo de accesorios personalizados.
-

Samsung prepara un millón de unidades del Galaxy Wide Fold para contrarrestar el iPhone Fold de Apple
Según se informa, Samsung se está preparando para lanzar su nuevo Galaxy Wide Fold con una producción inicial de un millón de unidades, lo que prepara el escenario para un importante enfrentamiento en el mercado de los teléfonos plegables.
-

Vivo presenta el X200T: un teléfono potente con Dimensity 9400+, batería de 6200 mAh y triple cámara Zeiss
Vivo lanzó oficialmente el X200T en India, un nuevo teléfono inteligente de gama media a alta impulsado por MediaTek Dimensity 9400+ y que cuenta con una versátil cámara triple ajustada por Zeiss.
-

Mouse Computer Unveils NEXTGEAR Case with Instantly Switchable Transparent-to-Frosted Glass
Japanese PC maker Mouse Computer has launched the innovative NEXTGEAR Clear Shift case, featuring a glass side panel that can instantly switch between transparent and frosted modes.
-

Samsung presenta la edición especial del Galaxy Z Flip7 para los Juegos Olímpicos de Invierno de Milano Cortina 2026
Samsung ha lanzado una edición especial del Galaxy Z Flip7 para los Juegos Olímpicos de Invierno Milano Cortina 2026, con un diseño único en dorado y azul para los atletas que compiten.
-

Filtraciones del DJI Osmo Pocket 4: sensor de 1 pulgada, modelo Pro con cámara dual y fecha de lanzamiento (29 de enero)
Los carteles filtrados revelan la serie DJI Osmo Pocket 4, que incluye una versión estándar con un sensor de 1 pulgada y un nuevo y potente modelo Pro de doble cámara que se lanzará más adelante.
-

Los Galaxy Buds 4 de próxima generación de Samsung se filtran y revelan un nuevo y elegante diseño.
La serie Galaxy Buds 4 de próxima generación de Samsung se ha revelado de manera extraoficial a través de las propias aplicaciones de la compañía, mostrando un nuevo diseño de tallo más plano e insinuando numerosas actualizaciones funcionales.
-

REDMI Turbo 5 Max se prepara para dominar con una enorme batería de 9000 mAh y un chip Dimensity 9500s
Las especificaciones filtradas del REDMI Turbo 5 Max revelan una enorme batería de 9000 mAh, un nuevo y potente chipset y una carga rápida de 100 W antes de su lanzamiento el 29 de enero.
-

Diseño y especificaciones del iQOO 15 Ultra: un vistazo al 'Future Pod' y al Snapdragon 8 Elite Gen5
Primer vistazo al diseño oficial 'Future Pod' del iQOO 15 Ultra y la iluminación 'Energy Blade', además de un análisis profundo de sus potentes especificaciones filtradas.
-

Xiaomi presenta el peine masajeador de cabeza inteligente Mijia con sistema de calentamiento de grafeno
Xiaomi lanza el Mijia Smart Head Massage Comb, un dispositivo de alta tecnología para el cuidado del cuero cabelludo con calentamiento de grafeno, control mediante aplicación y un diseño resistente al agua para una relajación máxima.
-

Keychron presenta la serie V Ultra 8K: frecuencia de sondeo de 8000 Hz y batería con 660 horas de duración
Keychron lanza la serie V Ultra 8K, que ofrece conectividad tri-modo, una tasa de sondeo de 8000Hz, firmware ZMK y una increíble duración de batería inalámbrica de 660 horas para un rendimiento de nivel profesional.
-

¡Con un precio de $400,000! ¿Acaso el primer televisor plegable del mundo es un indicio de la próxima batalla de los televisores de alta gama?
El televisor triple de 400.000 dólares de Porsche Design y C SEED ya está aquí y genera un debate sobre si los formatos innovadores definirán el futuro de la televisión de alta gama.
-

Análisis práctico del RedMagic 11 Air: el diseño transparente y en abanico regresa triunfalmente
El RedMagic 11 Air marca el regreso de la icónica parte posterior transparente y el ventilador de enfriamiento incorporado a la serie de teléfonos para juegos livianos de la marca, con potencia insignia y una batería enorme.
-

Raspberry Pi presenta su primera unidad flash oficial centrada en el rendimiento y la fiabilidad
Raspberry Pi presenta su Flash Drive oficial, una solución de almacenamiento USB-A duradera y de alto rendimiento disponible en capacidades de 128 GB y 256 GB, diseñada para brindar confiabilidad y velocidad.
-

Se filtra el nuevo hardware de inteligencia artificial de Apple: ¿un sucesor del iPhone o una repetición del fallido AI Pin?
Apple está desarrollando en secreto un dispositivo portátil de inteligencia artificial que recuerda al fallido AI Pin, y que podría venir incluido con el iPhone 19. ¿Se trata de una estrategia de cobertura o de la próxima gran novedad?
-

Se anuncian los Redmi Buds 5 Pro: un sistema coaxial de triple controlador excepcional para un sonido premium.
Redmi ha presentado oficialmente los nuevos Redmi Buds 5 Pro, que cuentan con un innovador sistema de triple controlador coaxial, audio espacial y soporte inalámbrico de alta resolución para una experiencia de audio incomparable.
-

Se anuncia REDMI Pad 2 Pro: una tableta potente con una batería de 12.000 mAh y 69 días de autonomía
El nuevo REDMI Pad 2 Pro de Xiaomi ya está aquí, con una increíble batería de 12,000 mAh con 69 días de duración en espera, una gran pantalla de 2.5K y capacidades de banco de energía.
-

La mini PC Slimbook ONE recibe una importante actualización con AMD Ryzen AI 9 HX 370 y OCuLink
El fabricante de PC español Slimbook ha renovado su mini PC ONE, que ahora ofrece nuevas y potentes opciones de CPU AMD Ryzen, incluido el AI 9 HX 370 y una versátil conectividad OCuLink.
-

El robot aspirador todoterreno: una mirada práctica al Roborock G30S Pro y su potencia para superar obstáculos de 8,8 cm
Conoce el Roborock G30S Pro. Este robot aspirador todoterreno cuenta con un revolucionario sistema de inteligencia artificial Wheel-Leg, que supera obstáculos de hasta 8,8 cm y ofrece una experiencia de limpieza automatizada superior.
-

Marshall presenta Heddon Hub: Actualice sus altavoces Bluetooth con sincronización multisala
Marshall presenta el centro de transmisión Heddon, un nuevo dispositivo que agrega capacidades de reproducción sincronizada en múltiples habitaciones a sus parlantes Bluetooth existentes utilizando la innovadora tecnología Auracast.
-

Análisis de la Gigabyte AORUS RTX 5060 Ti AI BOX: Una base para potencia, transferencia y rendimiento
La Gigabyte AORUS RTX 5060 Ti AI BOX transforma las computadoras portátiles delgadas en potencias de rendimiento para juegos e inteligencia artificial, con Thunderbolt 5 y una GPU de clase de escritorio.
-

La Instax mini Evo Cinema de Fujifilm: la cámara más divertida que no puedo recomendar
Reseña de la Fujifilm Instax mini Evo Cinema. Esta cámara es increíblemente divertida y tiene un fantástico diseño retro, pero sus principales defectos técnicos la hacen imposible de recomendar.
-

La primera ola de productos de Apple para 2026: MacBooks M5 radicales y un modelo económico que cambia las reglas del juego
La primera ola de 2026 de Apple incluye nuevas MacBooks M5 Pro/Max, un rumoreado modelo económico y pantallas mejoradas, que revolucionarán el mercado de PC.
-

La Legión de Robots Asiáticos: Dominando Las Vegas en el CES 2026
El CES 2026 está dominado por una nueva ola de robots procedentes de Asia, que abarcan desde trabajadores humanoides y compañeros emocionales hasta robots de limpieza altamente especializados que conquistan cada rincón.
-

¡Adiós al teléfono de ladrillo! Análisis del RedMagic 11 Air: Un cuerpo ultrafino con ventilador integrado y una sensación increíble.
El RedMagic 11 Air desafía los estereotipos de los teléfonos para juegos con su diseño ultradelgado, ventilador incorporado y sensación increíble, ofreciendo un rendimiento de primer nivel sin volumen.
-

Se filtra el prototipo de cámara de bolsillo modular con estabilizador y lente Leica de Insta360
Imágenes filtradas revelan el innovador prototipo de cámara de bolsillo modular de Insta360. Incorpora un módulo de lente Leica desmontable que se puede acoplar a un estabilizador para una versatilidad máxima.
-

Informe de Omdia: Vivo dominará el mercado de teléfonos inteligentes de la India en 2025 en medio de un declive general
El informe 2025 de Omdia destaca el dominio de vivo en el mercado de teléfonos inteligentes en declive de la India, con una ventaja significativa sobre Samsung y OPPO.
-

Pulsar presenta los ratones X2 CrazyLight con temática de "Archivo Azul" y personajes de Abydos
Pulsar ha anunciado una nueva colaboración con 'Blue Archive', lanzando tres ratones X2 CrazyLight de edición especial inspirados en personajes populares de Abydos High School.
-

Pivote estratégico de DJI: ¿Es el Xtra ATTO un Osmo Nano renombrado para América del Norte?
Se rumorea que DJI está rebautizando su popular cámara Osmo Nano como Xtra ATTO, una decisión estratégica destinada a sortear las posibles barreras comerciales de Estados Unidos.
-

Se filtran renders de la Lenovo Idea Tab Pro Gen 2, que revelan un rediseño elegante y una cámara cápsula.
Los renders filtrados revelan el nuevo diseño minimalista de la Lenovo Idea Tab Pro Gen 2, que cuenta con una cámara de cápsula única, cuatro altavoces y un conjunto completo de accesorios de productividad.
-

Realme Neo8 redefine la fotografía de gama media con zoom periscopio de 50 MP
Realme se dispone a redefinir la fotografía de gama media y anuncia que el Realme Neo8 contará con un potente teleobjetivo periscopio de 50 MP con una increíble capacidad de súper zoom de 120x.
-

Lanzamiento de dos buques insignia de Honor: el Magic8 Pro Air "Pro First" y un nuevo diseño Porsche
El último lanzamiento de Honor presenta el Magic8 Pro Air, un teléfono ultradelgado de nivel "Pro", y el Magic8 RSR Porsche Design, que desafía las convenciones del mercado con especificaciones sin concesiones.
-

Realme Buds Air6 Pro: ¡Ya puedes reservar los auriculares con cancelación de ruido de 55 dB!
Realme ha anunciado sus nuevos Buds Air6 Pro, ya disponibles para reservar. Los auriculares cuentan con una potente cancelación de ruido de 55 dB y su lanzamiento está previsto para el 22 de enero.
-

La guerra de los teleobjetivos en los smartphones: zoom continuo, doble vista y doble zoom de 200 MP
Una batalla por la supremacía del teleobjetivo: zoom óptico continuo, periscopios de doble vista y sensores duales de 200 MP. Descubre qué tecnología definirá el futuro de la fotografía con smartphones.
-

La gran apuesta de Apple: asociarse con Google Gemini para reinventar Siri: ¿un desafío para la ventaja de inteligencia artificial de los teléfonos chinos?
La sorprendente alianza de Apple con Google para potenciar Siri con Gemini AI amenaza la ventaja que largamente tienen las marcas de teléfonos chinas y podría transformar todo el panorama de la inteligencia artificial móvil.
-

¿El fin de una era? Vision Pro, según se informa, se detiene ante el declive de la computación espacial de Apple.
Ahora que se informa que el Vision Pro de Apple enfrenta una detención de su producción, analizamos los errores que condenaron al ambicioso dispositivo de computación espacial, desde su asombroso precio hasta su ecosistema cerrado.
-

Realme Neo 8 debutará globalmente con la primera pantalla Samsung de 165 Hz del mundo
El próximo Realme Neo 8 está listo para su debut mundial, con una innovadora pantalla Samsung de 165 Hz que promete una experiencia visual incomparable para los usuarios.
-

El lanzamiento de RedMagic 11 Air está previsto para el 20 de enero y anticipa el regreso del ventilador y un futuro de "pantalla completa real".
RedMagic presentará el nuevo RedMagic 11 Air el 20 de enero, con rumores que sugieren el regreso de su icónico ventilador de refrigeración y una futura pantalla completa.
-

Filtrado: El nuevo procesador Core G3 de Intel apunta a impulsar los dispositivos portátiles para juegos de próxima generación
Intel está ingresando a la escena de los juegos portátiles con su procesador Core G3 recientemente filtrado, que presenta una arquitectura híbrida Panther Lake y gráficos Arc B380 para un rendimiento de rango medio.
-

¿El próximo buque insignia de Redmi? Rumores apuntan a un Dimensity 9500 con refrigeración activa e IP68.
Se informa que un nuevo teléfono Xiaomi Redmi está en pruebas y se rumorea que contará con el poderoso chip Dimensity 9500, un ventilador de refrigeración incorporado y una sorprendente clasificación teórica de resistencia al agua IP68.
-

MSI presenta sus portátiles ultradelgados y modernos 14S y 16S en el CES 2026
MSI lanza sus nuevas computadoras portátiles convencionales Modern 14S y 16S en CES 2026, con un diseño increíblemente delgado y liviano impulsado por procesadores Intel Core Ultra de próxima generación.
-

¿Se acabaron los teléfonos "pequeños y bonitos"? ASUS detiene su negocio de telefonía móvil mientras las marcas de nicho se acercan al límite.
ASUS está deteniendo sus líneas de teléfonos Zenfone y ROG, lo que señala una dura realidad para las marcas de teléfonos inteligentes de nicho en un mercado que prioriza la escala sobre el diseño único.
-

CES 2026: Los refrigeradores Family Hub de Samsung se actualizan con puertas controladas por voz.
Los refrigeradores Family Hub 2026 de Samsung, presentados en CES, cuentan con puertas controladas por voz y Gemini AI para una experiencia de cocina más inteligente y manos libres.
-

"IA en cada producto": Samsung se compromete a integrar IA en 500 millones de dispositivos anuales
Samsung se dispone a revolucionar su línea de productos integrando IA en cada dispositivo, aprovechando su envío anual de 500 millones de unidades para crear un ecosistema inteligente y perfecto.
-

¿Se retrasa la PS6 por el precio de la memoria? Sony aún no ha decidido, pero la producción de APU sigue prevista para 2027.
Informes contradictorios sobre un posible retraso de la PS6 debido al precio de la memoria. Aunque Sony aún no ha tomado una decisión, su programa de producción de APU con AMD sigue en marcha para 2027.
-

Avance de smartphones para enero de 2026: buques insignia pequeños, juegos aéreos y un mercado de gama media despiadado
Enero de 2026 inicia una nueva guerra de teléfonos inteligentes con pequeños buques insignia, teléfonos para juegos livianos, nuevos teléfonos plegables y un mercado de gama media despiadado que ofrece dispositivos altamente especializados.
-

EPOMAKER presenta el HE30: un teclado con interruptor magnético de una mano para gamers
EPOMAKER presenta el HE30, un teclado compacto con interruptor magnético de una mano para jugadores, que cuenta con una frecuencia de sondeo de 8 kHz y tecnología Rapid Trigger ultraprecisa para una ventaja competitiva.
-

HyperX en CES 2026: Presenta un controlador arcade TMR y teclados con interruptores magnéticos
HyperX se dispone a presentar su línea de productos en CES 2026, que incluye un innovador controlador arcade TMR, teclados con interruptores magnéticos avanzados y un ecosistema de software NGENUITY renovado.
-

Especificaciones del realme 16 Pro+ reveladas: Snapdragon 7 Gen 4, cámara de 200 MP y una enorme batería de 7000 mAh
realme presenta el 16 Pro+ con un chip Snapdragon 7 Gen 4, una cámara de 200MP y una enorme batería de 7000mAh, apuntando al mercado de gama media alta.
-

La cámara Kodak de 30 dólares que se está agotando: ¿Un genio nostálgico o una lucha final?
La cámara llavero Charmera de Kodak es un fenómeno viral a pesar de su mala calidad de imagen. Este pequeño dispositivo de inspiración retro combina la nostalgia con una ingeniosa estrategia de marketing de caja ciega.
-

Análisis práctico del Honor WIN: un dispositivo gaming de 10 000 mAh con ventilador integrado y teleobjetivo 3x
El teléfono para juegos Honor WIN supera los límites con su enorme batería de 10,000 mAh, ventilador de enfriamiento activo y un teleobjetivo 3x versátil, brindando un rendimiento que supera las expectativas.
-

Análisis en profundidad del Xiaomi 17 Ultra: zoom óptico continuo + triplete de lente APO: ¿se adelantó el teléfono del año?
Una mirada en profundidad al Xiaomi 17 Ultra, que cuenta con una revolucionaria cámara con zoom óptico continuo, una lente APO y una calidad de imagen excepcional que establece un nuevo estándar en la industria.
-

Análisis del Honor 500 Pro: un teléfono de gama media de manual con un tacto y una duración de batería excepcionales
El Honor 500 Pro eleva el listón de los teléfonos de gama media con su impresionante diseño, potente cámara de 200 MP, batería de 8000 mAh y un rendimiento excepcional. Un auténtico todoterreno.
-

Análisis de la DJI Osmo Action 6: ¿El nuevo pináculo de la calidad de imagen en cámaras de acción?
La DJI Osmo Action 6 establece un nuevo estándar con su innovadora apertura variable, su versátil sensor cuadrado y su fenomenal duración de la batería, convirtiéndola en la herramienta definitiva para la grabación de vídeo de acción.
-

Análisis de la Insta360 X4 Air: Cámaras 360 accesibles y fáciles de usar para principiantes
La Insta360 X4 Air ofrece un equilibrio perfecto entre calidad 8K, portabilidad y un precio asequible, lo que la convierte en la cámara 360 ideal para principiantes que desean capturarlo todo.
-

Análisis de Nothing Ear 3: Donde el diseño impactante encuentra por fin su complemento sonoro.
Los auriculares Nothing Ear 3 destacan por su icónico diseño transparente y, finalmente, ofrecen una calidad de sonido equilibrada e impresionante, lo que los convierte en una rara combinación de estilo y sustancia.
-

Primer vistazo al Redmi K90 Pro Max: ¿Es el audio innovador la clave del éxito?
Revisión del Redmi K90 Pro Max: un buque insignia que se destaca por su rendimiento de primer nivel y un revolucionario sistema de sonido 2.1 con tecnología BOSE, abriendo un nuevo camino.
-

Análisis del iQOO 15: Rendimiento perfecto para juegos, pero la fotografía tiene sus límites
El iQOO 15 ofrece un rendimiento de juego impecable con su nuevo chip Snapdragon y pantalla 2K de 144 Hz, pero sus capacidades de cámara revelan algunas desventajas para su diseño centrado en los juegos.
-
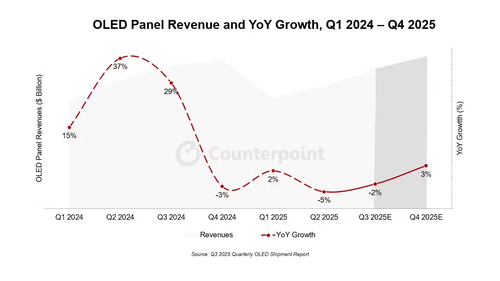
Pronóstico del mercado global de OLED para 2025: Samsung Display liderará con una participación de ingresos del 41%, según CounterPoint
El pronóstico del mercado OLED para 2025 de CounterPoint Research muestra que Samsung Display lidera con una participación de ingresos del 41%, en medio de una recuperación del mercado impulsada por computadoras portátiles y monitores.
-

El ascenso y la rápida caída del botón de la cámara: ¿ha terminado el experimento de Apple?
Se rumorea que el botón de cámara de Apple, antes considerado una función profesional y copiado por la competencia, está a punto de desaparecer. Aquí te contamos qué falló.
-

Informe: Los cartuchos de Nintendo Switch 2 usarán 3D NAND para reducir costos y aumentar la capacidad
Un informe del socio de la cadena de suministro Macronix sugiere que los cartuchos de juegos de Nintendo Switch 2 utilizarán flash NAND 3D, con el objetivo de lograr costos más bajos y mayores capacidades de almacenamiento.
-

El mercado mundial de teléfonos inteligentes alcanza un récord de 100 mil millones de dólares en el segundo trimestre de 2025; Apple domina los ingresos.
El mercado mundial de teléfonos inteligentes alcanzó un récord de 100 mil millones de dólares en ingresos en el segundo trimestre de 2025, con Apple capturando el 43% del total, según un nuevo informe de Counterpoint Research.